Это 1-я статья из цикла.
2-я статья - Mapper — наш, или еще одна технология электронно-много-лучевой литографии
3-я статья - KLA-Tencor — революция в много-лучевой электронной литографии
Для начала о проблеме
Из каждого «утюга» мы слышим о нанометрах в микроэлектронике. Те, кто чуть глубже погружен в тему слышали о том, что для получения заветных нанометров используют литографы и что самые продвинутые производители микросхем переходят с литографов на DUV (Deep Ultra-Violet, Глубокий ультрафиолет с длиной волны 193 нм) на EUV (Extreme Ultra-Violet, Экстремальный ультрафиолет с длиной волны 13,5 нм).
Но чтобы получить рисунок на пластине, нужно сначала получить его на фотошаблоне. Причем рисунок на фотошаблоне зачастую бывает намного сложнее, чем получаемый в итоге отпечаток на кремниевой пластине. Это делается для подавления эффекта «близости» и подавления эффектов возникающих из-за дифракции.

Хотя размер рисунка фотошаблона обычно в 4 раза больше итогового рисунка на пластине, точность его изготовления должна быть не хуже точности рисунка на пластине, т.к. все «рваные» края и «округлые» углы на фотошаблоне будут усилены на пластине более чем в 4 раза.
До некоторого предела, а точнее, для фотошаблонов на техпроцесс до 180 нм используют лазерные генераторы фотошаблонов. Но для техпроцессов от 180 нм и меньше уже невозможно, используя лазерный луч, добиться точности, необходимой для фотошаблонов. И здесь начинается использование электронно-лучевых литографов. Т.к. длина волны у электрона на несколько порядков меньше длины ультрафиолетового излучения, то появляется возможность рисовать лучом из электронов структуры с точностью до 1-5 нм.
Но… как всегда возникает это «но»…
Скорость засветки у электронно-лучевого литографа на порядки меньше скорости засветки у лазерного генератора фотошаблонов.
На один фотошаблон может потребоваться до нескольких суток, а если учесть что полный комплект фотошаблонов для микросхемы может состоять из 80 шт. этих фотошаблонов, то срок производства комплекта фотошаблонов (масок) может занять несколько месяцев.
Учитывая стоимость электронно-лучевого литографа (порядка 15 млн. USD) становится понятно, почему комплект масок для техпроцесса 130 нм может стоить 500 тыс. USD, а для продвинутого техпроцесса 7-14 нм может легко уйти за 10 млн. USD.
Может, стоит ускориться?
Да, это того стоит. Поэтому естественно родилась идея повторить принцип работы лазерных генераторов изображения, использующих для засветки до миллиона одновременно управляемых лазерных лучей. Эти лучи отражаются от микро-зеркал, которые программно «дергаются» и отбрасывают лазерный луч то на пластину (через специальное микро-отверстие), то мимо (на поглотитель). Так формируется изображение на засвечиваемой пластине.
Выглядит красиво – сотни тысяч, или даже миллион электронных лучей, одновременно облучают пластину с невероятной точностью в 1-5 нм. Мы получаем технологию, при которой возможно вообще отказаться от столь дорогостоящего звена как фотошаблоны. И возможно производство прототипов, малых и средних партий микросхем по разумным ценам!
Но… Опять это «но»… «Гладко было на бумаге».
Отсюда начнем описание имеющихся вариантов технологий Электронно-много-лучевых технологий и проблем на пути их реализации.
Технология от IMS Nanofabrication (IMS-NANO) - самая «простая»
Самый скромный участник соревнований технологий электронно-много-лучевой литографии, но достигший осязаемых коммерческих результатов.
В рамках европейской программы MAGIC (MAskless lithoGraphy for IC manufacturing), были выделены 11,75 млн. евро на поддержку компаний MAPPER и IMS Nanofabrication.
Компания IMS Nanofabrication AG (Австрия) вначале развивала проект ионно-много-лучевого литографа CHARPAN (Charged Particle Nanotech).
К февралю 2009 года был создан образец доказывающий работоспособность концепции. На ионах водорода с энергией 10 кэВ при диаметре луча 12,5 нм на резисте HSQ было получено разрешение менее 16 нм. Количество лучей в матрице ~43’000 шт.
Но ионы водорода нежелательный элемент, остающийся в кремниевой подложке после засветки фоторезиста.
Поэтому, начиная с 2009 года, компания перенесла свое внимание на разработку электронно-много-лучевого литографа по проекту RIMANA (Radical Innovation Maskless Nanolithography), также при финансовой поддержке от Европейской комиссии. Причем, вначале использовались апертурная и гасящая матрица из проекта ионно-много-лучевой литографии.

Электронно-лучевая колона по проекту RIMANA позволяла использовать только 2’500 лучей из возможных 43’000. Поэтому с четвертого квартала 2009 года было начата работа над созданием новой колоны и матрицы для нее.
К 2013 году был собран электронно-лучевой литограф с матрицей на 262’144 (512х512) лучей с диаметром пятна каждого луча 20 нм.

Установка уровня доказательства концепции IMS-NANO – аппарат экспонирования фотошаблонов eMET (electron Mask Exposure Tool):
Кол-во программируемых лучей (# of programmable beams) | 262’144 шт. |
поток данных (Data path) | 12.8 Гбит/с |
энергия электронов (Beam energy) | 50 кэВ |
размер луча (Beam size) | 20 нм |
размытие (Column blur) | 5нм 1сигма |
сетка позиционирование луча (Address grid | 0.1 нм |
способ записи (Writing) | сканирование по столу |
общий ток колоны (Current) | 0.2-1 мкА |
производительность (TPT) | до 10 см2/час |
Компания решила увеличить размер пятна до 20 нм – это позволяет повысить производительность, увеличив ток пятна, а путем частичного смещения места засветки на неполный размер пятна и управлением времени засветки, возможно создания элементов топологии с размерами 1/3-1/2 от размера пятна.

Так при смещении пятна на половину его размера и времени засветки длительностью 33% от полного, возможно получение элемента топологии размером 10 нм. Литограф от IMS позволяет управлять смещением пятна с точностью до 0,1 нм
В IMS Nanofabrication решили не хватать звезд с небес – строить аппарат способный конкурировать с аппаратами проекционной литографии от ASML (монополиста на рынке литографии для микроэлектроники). В компании пошли по твердому пути – постройке электронно-лучевой колоны по классической схеме отработанной на электронно-лучевых микроскопах. С некритическим током электронной пушки и с небольшими токами в отдельных лучах.
Отказ от предельных токов, позволил использовать общепринятую электронно-оптическую схему с кроссоверами (местами где отдельные лучи пересекаются), и соответственно, использовать, хорошо изученные макро-линзы и макро-дефлекторы для управления и масштабирования всего пучка лучей сразу. Это значительно упростило электронно-оптическую схему и схемотехнические решения системы управления.
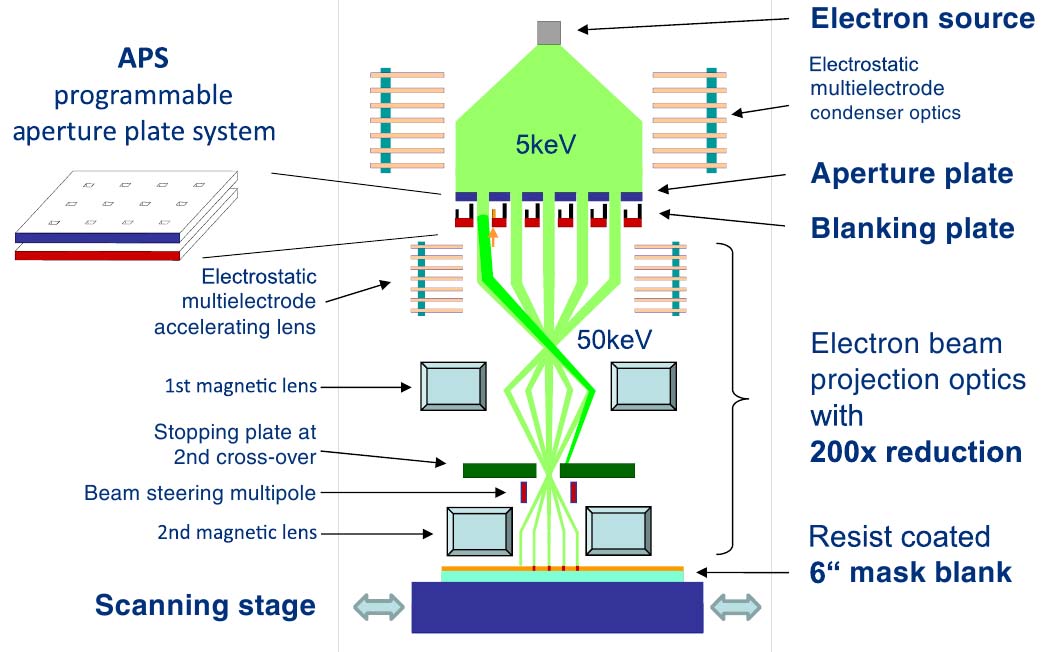
Поток электронов из электронного источника (Electron source), коллимируется электростатической конденсорной многоэлектродной оптикой (Electrostatic multielectrode condenser optic). Программируемой апертурной пластиной (APS), состоящей из апертурной пластины (Aperture plate) и гасящей пластины (Blanking plate) формируется пучок лучей. Электростатической многоэлектродной ускоряющей линзой (Electrostatic multielectrode accelerating lens) энергия электронов повышается до 50 кэВ и фокусируется в 1-й кроссовер.
1-я магнитная линза (1st magnetic lens) фокусирует пучок во 2-й кроссовер в центре апертурного отверстия останавливающей пластины (Stopping plate at 2nd cross-over). Электронный луч, который был немного отклонен гасящей пластиной (ярко-зеленый) не попадает во 2-й кроссовер, а поглощается останавливающей пластиной. С помощью многополюсной отклоняющей (дифлекторной) системы (Beam steering multipole) пучок электронов может отклоняться, тем самым засвечивая промежутки между лучами и компенсируя при необходимости движение непрерывно двигающегося сканируемого стола (Scanning stage). 2-я объектная магнитная линза (2nd magnetic lens) окончательно фокусирует пучок на пластине или фотошаблоне покрытом резистом (Resist coated 6” mask blank).
Общее масштабирование (уменьшение) создаваемое электронной оптикой составляет 200 крат (Electron beam projection optics with 200x reduction).
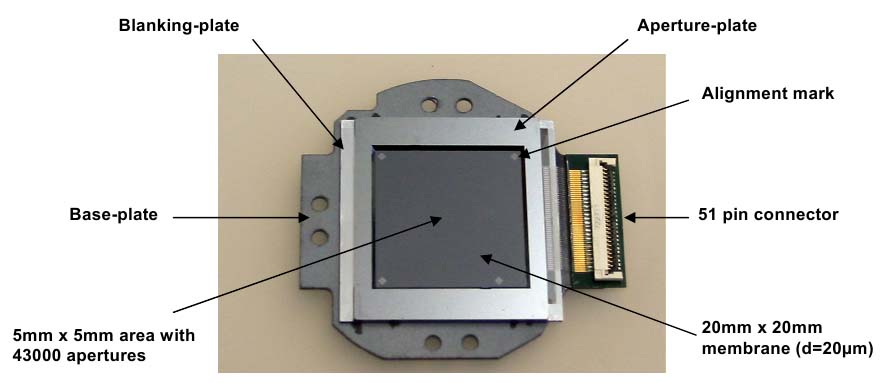
Хотя технология не обладает выдающимися показателями производительности (10 кв. см в час), относительно других технологий электронно-много-лучевой литографии, но на порядок превосходит производительность электронно-одно-лучевой литографии.
А относительная простота, позволила довести ее до коммерческого промышленного уровня для производства фотошаблонов. На текущий момент компания расширяет свое присутствие на рынках Тайваня, Южной Кореи и США.
Первые результаты экспонирования:
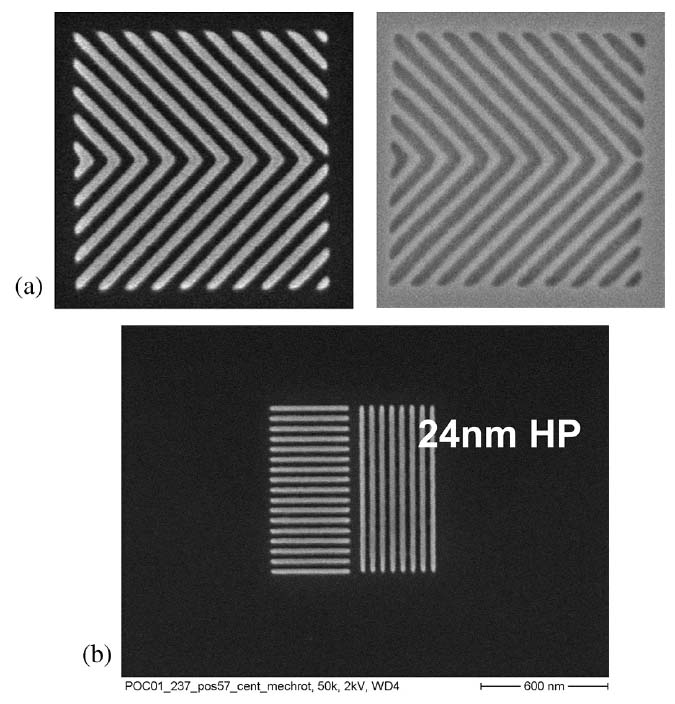

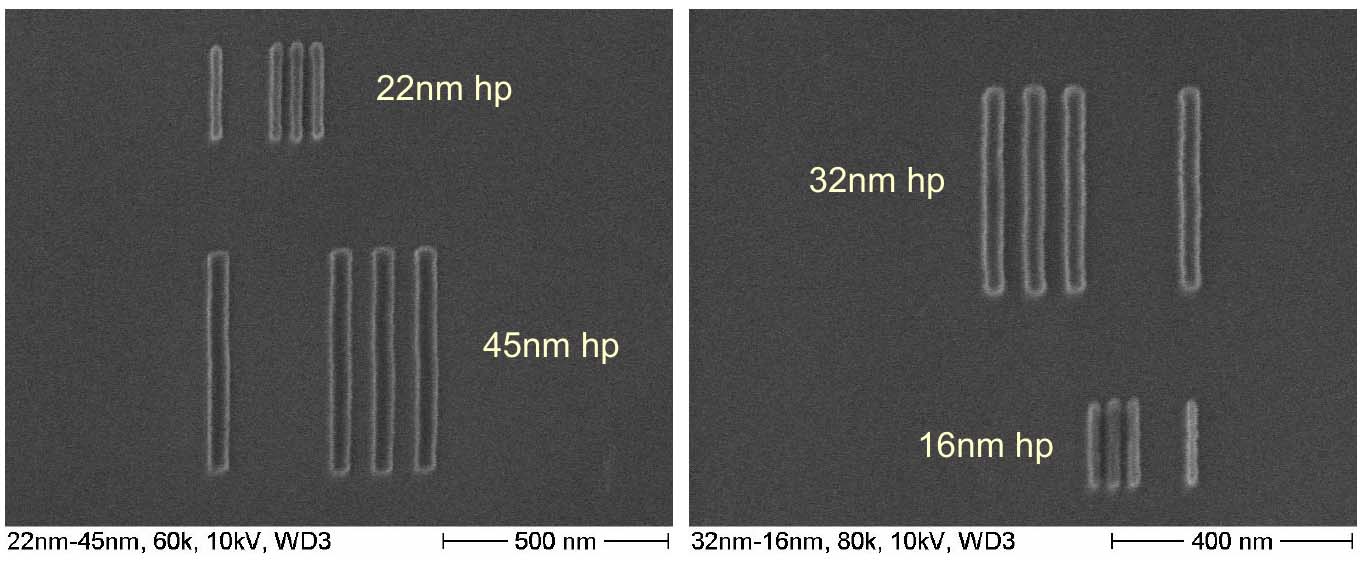
Показанные на картинках первые результаты сравнимы с лучшими показателями для EUV литографии (длина волны 13,5 нм) от ASML, но скорость засветки не позволяет конкурировать с технологией проекционной литографии для массового производства микросхем. Рынком для технологии от IMS Nanofabrication остается рынок фотошаблонов, (кстати достигший в 2021 году 4,2 млрд USD), рынок прототипов и малых партий микросхем.
Это 1-я статья из цикла.
2-я статья - Mapper — наш, или еще одна технология электронно-много-лучевой литографии
3-я статья - KLA-Tencor — революция в много-лучевой электронной литографии






