Хабр Курсы для всех
РЕКЛАМА
Практикум, Хекслет, SkyPro, авторские курсы — собрали всех и попросили скидки. Осталось выбрать!
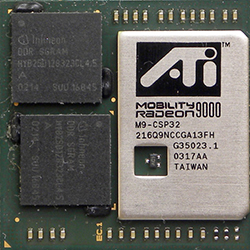
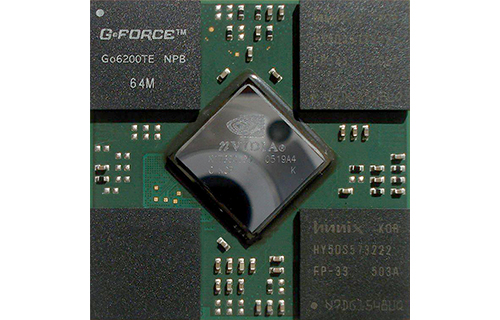
Согласно утечкам, трёхсотая серия будет представлена 18 июня, а R9 390X покажут 24 июня.
First, there is a big debate regarding whether passive interposers will need to be tested or whether the yield will be so high they won’t warrant testing. Second, what is necessary to adequately test a die that is 50-µm thick with 100,000 microbumps? Third, how will you power up and test a die that only has 2-µm diameter pads?..
As for interposers, Fleeman agreed with Strid at Cascade that there is a “huge concern in the industry over interposer yield.” However, Fleeman said, “Interposer suppliers plus tool providers like Applied Materials say the yield is virtually perfect” for the 65-nm three- or four-layer metal structures.
“Loss due to assembly or transport wouldn’t be caught in the interposer test anyway,” he continued. “For RDL [redistribution layer] and basic interposers, we don’t think there is a production [test] requirement. Line monitoring already is accomplished by very good picoamp DC testing and X-ray and optical inspection.
You can have either active or passive interposers, active have logic/transistors on them, passive have only metal layers. This is the long way of saying an active interposer is a very simple and large chip, a passive one skips the transistors and only prints metal layers aka wires. This again translates into active being fairly expensive and passive being very cheap. You can print as many metal layers as you want on an interposer but each layer dramatically ups the cost.
AMD went for passive interposers and did not say how many metal layers they used but SemiAccurate speculates they didn’t go above three if they even hit that many. They are made at UMC on an undisclosed process that was strongly hinted to be either a 40nm or 65nm process. In short it is on a very old and inexpensive process and has a very small number of steps at that. Interposers are dirt cheap per mm^2 of area compared to chips built on the same outdated process.
Первые видеокарты на High Bandwidth Memory от AMD появятся уже через несколько месяцев